Samsung’un bir raporuna göre, Samsung bu yıl yüksek bant genişlikli bellek (HBM) için 3D paketleme hizmetlerini tanıtmaya hazırlanıyor. Kore Ekonomik Günlük Burada şirketin San Jose’deki Samsung Foundry Forum 2024’teki duyurusunun yanı sıra “endüstri kaynaklarına” da yer veriliyor. HBM için 3D paketleme, esasen 2025 – 2026 sonlarında HBM4 entegrasyonunun önünü açıyor, ancak Samsung’un bu yıl ne tür bir bellek paketleyeceğinden emin değiliz.
3D paketleme için Samsung, üç farklı 3D istifleme teknolojisini içeren SAINT (Samsung Gelişmiş Ara Bağlantı Teknolojisi) adlı bir platforma sahiptir: SRAM için SAINT-S, mantık için SAINT-L ve CPU’lar gibi mantık yongalarının üzerinde DRAM istiflemesi için SAINT-D. veya GPU’lar. Şirket birkaç yıldır SAINT-D üzerinde çalışıyor (ve bunu resmi olarak 2022’de duyurdu) ve öyle görünüyor ki teknoloji bu yıl prime time’a hazır olacak; bu, dünyanın en büyük bellek üreticisi ve lider üreticisi için dikkate değer bir kilometre taşı olacak. dökümhane.
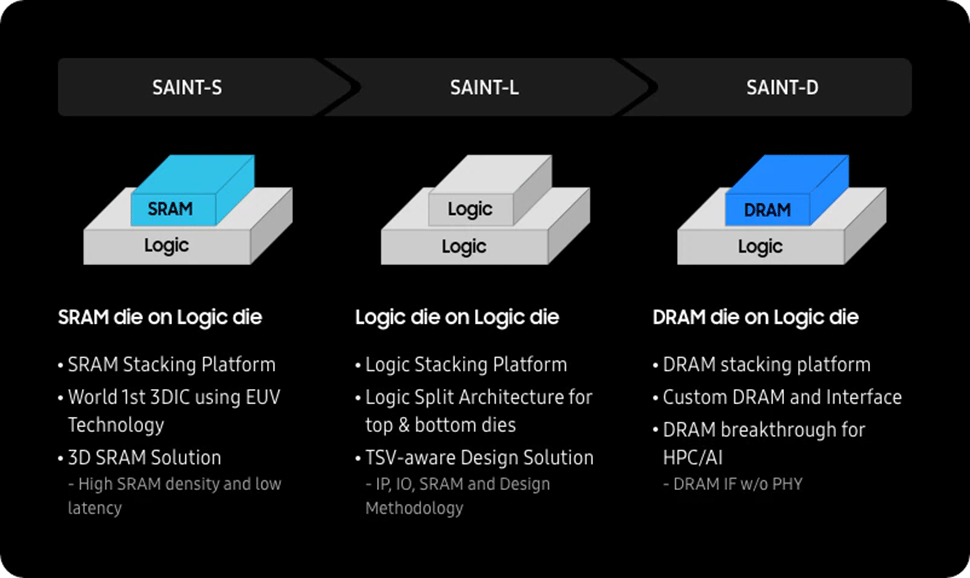
Samsung’un yeni 3D paketleme yöntemi, HBM çiplerini işlemcilerin üzerine dikey olarak istiflemeyi içeriyor; bu, HBM çiplerini ve GPU’ları silikon bir ara eleman aracılığıyla yatay olarak bağlayan mevcut 2.5D teknolojisinden farklı. Bu dikey istifleme yaklaşımı, silikon ara elemana olan ihtiyacı ortadan kaldırır ancak HBM belleği için karmaşık bir işlem teknolojisi kullanılarak yapılan yeni bir temel kalıp gerektirir.
3D paketleme teknolojisi HBM için daha hızlı veri aktarımı, daha temiz sinyaller, azaltılmış güç tüketimi ve daha düşük gecikme süreleri dahil olmak üzere önemli avantajlar sunar, ancak nispeten yüksek paketleme maliyetlerine sahiptir. Samsung, bu gelişmiş 3D HBM ambalajını, bellek iş bölümünün HBM çipleri ürettiği ve dökümhane biriminin, kusursuz şirketler için gerçek işlemcileri monte ettiği, anahtar teslimi bir hizmet olarak sunmayı planlıyor.
Belirsiz kalan şey ise Samsung’un bu yıl SAINT-D ile tam olarak ne sunmayı planladığı. HBM’yi bir mantık kalıbına yerleştirmek, uygun bir çip tasarımı gerektirir ve HBM’yi zirvede tutacak şekilde tasarlanmış ve 2024 – 2025’in ilk yarısında piyasaya sürülmesi planlanan tanınmış şirketlere ait herhangi bir işlemciden haberdar değiliz.

İleriye baktığımızda Samsung, 2027 yılına kadar hepsi bir arada heterojen entegrasyon teknolojisini sunmayı hedefliyor. Geleceğin bu teknolojisi, iki katman mantık yongasının, HBM belleğin (aracıda) ve hatta ortak paket optiklerin (CPO’lar) entegrasyonunu sağlayacak.
